网站分类
搜索
最新留言
文章归档
友情链接
芯片封装类型简介
芯片封装是半导体产业中重要的一环,它不仅保护着脆弱的半导体芯片,还承担着散热、电气连接和信号传输等多重功能。从最早的通孔封装(如DIP)到表面贴装封装(如QFP),再到区域阵列封装(如BGA)和晶圆级封装(如WLCSP),芯片封装技术向着小型化、高性能的方向发展。本文将由简到繁、图文并茂的介绍常见的芯片封装类型,并对它们的特点和应用做简要说明。
1 芯片封装分类
芯片封装按照安装方式可分为插件封装(也称为通孔封装,Through-Hole Package)和表面贴装封装(Surface Mount Package)两大类。通孔封装是早期的封装形式,其引脚需要插入PCB板的通孔中进行焊接,表面贴装封装则是将器件直接焊接在PCB板表面。
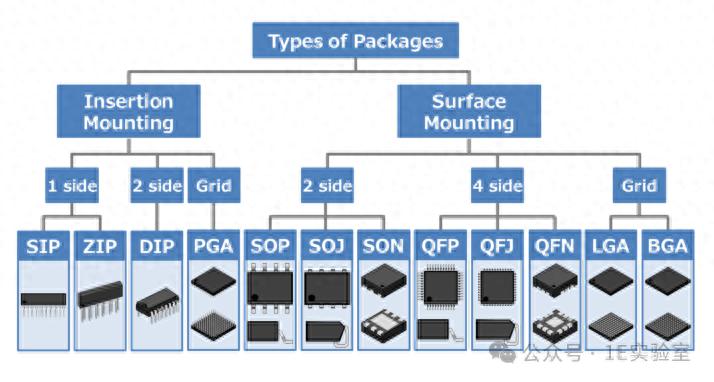
芯片封装分类
芯片封装按引脚排列方式又可以细分为:单列引脚型,双列(两侧)引脚型,四边引出型和阵列型,这种演进反映了芯片封装技术从低密度向高密度发展的趋势。
2 插件封装
2.1 二极管封装(DO),晶体管封装(TO)
DO(Diode Outline)与TO(Transistor Outline)分别是二极管和晶体管的传统封装形式,通常属于插件封装。市面上有很多标准化的封装型号,例如DO-35,DO-41,TO-92,TO-220等。虽然二极管和晶体管属于半导体器件中的分立元件,不属于芯片的范畴,但在此也一并介绍其封装类型。
二极管与晶体管封装
2.2 单列直插封装(SIP),锯齿形单列直插封装(ZIP)
单列直插封装,SIP(Single In-line Package)是指引脚从封装单侧引出,呈单列直线排列的封装形式。SIP的结构简单,成本低,适用于排阻,小功率二极管等器件。
锯齿形单列直插封装,ZIP(Zig-Zag In-line Package)的引脚同样从封装单侧引出,但呈“Z”字形或“V”字形分两排交错排列,提高了引脚密度,常用于电源模块、放大器等。

SIP与ZIP封装
2.3 双列直插封装(DIP)
双列直插封装,DIP(Dual In-line Package)是一种经典的集成电路封装,其特点是具有长方形外壳、两侧对称排列的两排金属引脚。其标准引脚间距为2.54mm(0.1英寸),型号后缀数字表示引脚数量(如DIP14即表示有14个引脚)。DIP封装广泛应用于上世纪70-80年代的电子设备,凭借与面包板的兼容性与插拔便捷性,它也常用于现代的教育实验。DIP在欧洲也被称为DIL(Dual In-Line)。

DIP封装
根据封装外壳的材质,DIP可以分为CDIP(Ceramic DIP,陶瓷封装)和PDIP(Plastic DIP,塑料封装)两类。陶瓷DIP可靠性高,可以耐受极端环境,但是价格约是塑料DIP的数倍。
2.4 插针网格阵列封装(PGA)
插针网格阵列封装,PGA(Pin Grid Array)的底部为方阵排列的垂直金属插针,标准引脚间距为2.54mm,引脚数一般为64到528个。相比DIP,PGA的引脚密度更高,且同样具有插拔便捷性。
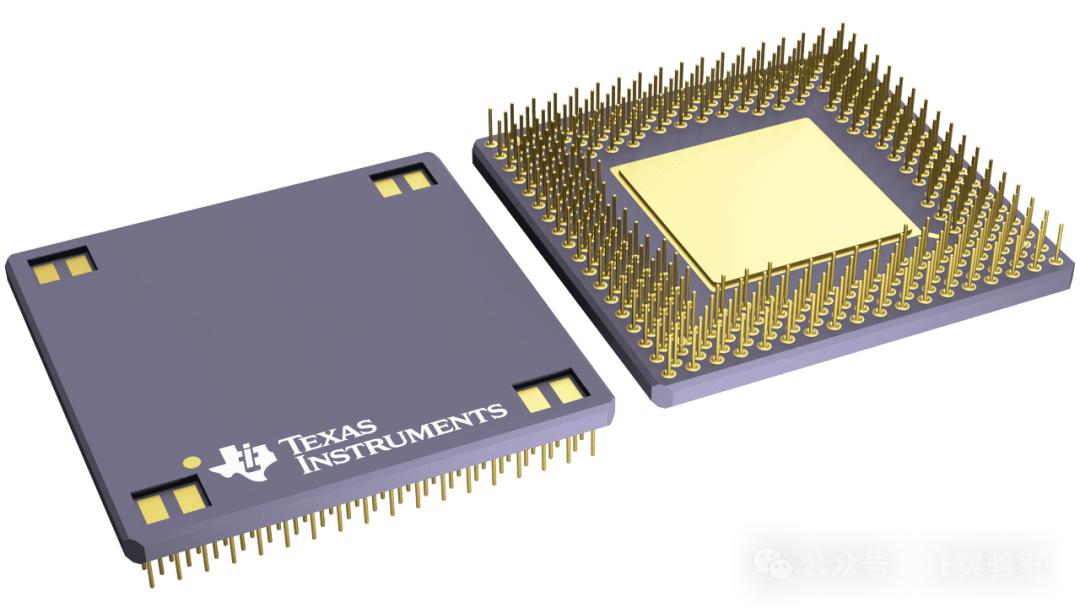
PGA封装
3 表面贴装封装
3.1 小外形二极管(SOD),小外形晶体管(SOT)
SOD(Small Outline Diode)是二极管最常用的封装形式,属于表面贴装类型。SOD封装通常有2个引脚,尺寸一般小于1.6mm×1.2mm,常见型号如SOD-123、SOD-323和SOD-523。
SOT(Small Outline Transistor)是晶体管最常用的封装形式,也属于表面贴装类型。SOT封装通常有3~6个引脚,例如SOT-23-6中23表示封装标准型号,6为引脚数量,引脚数量也可以隐去不提。

常见的SOD与SOT封装
3.2 两侧引出型表面贴装封装
两侧引出型表面贴装封装有三大类:SOP, SOJ, SON。前两个字母SO表示Small Outline,概括了这类封装的小外形的特点。最后一个字母表示引脚类型:P表示Package,对应常规引脚;J对应J形引脚;N表示No-lead,对应无引脚。
3.2.1 小外形封装(SOP)
SOP(Small Outline Package)是在DIP封装的基础上改进而来,即:将DIP封装的引脚变短并向外展开,变为表面贴装,提高PCB的布局密度。SOP封装的特征是“两侧具有海鸥翼形(L形)引脚”,引脚间距一般为1.27mm,引脚数量通常在8~44之间。

SOP封装
SOP封装在小型化过程中又衍生出很多改进型:
SSOP(Shrink SOP):缩小型小外形封装,引脚中心距小于1.27mm;
TSOP(Thin SOP):薄型小外形封装,封装高度低于1.27mm;
VSOP(Very SOP):甚小外形封装,进一步缩小体积;
还有更小型的封装类型:TSSOP(Thin Shrink SOP);TVSOP(Thin Very-thin SOP);VSSOP(Very-thin Shrink SOP)。使用SOP封装的IC也称为SOIC(Small Outline Integrated Circuit)。
此外,还有带散热设计的封装HSSOP(Heat Sink Shrink SOP),HSOIC(Heat Sink Small Outline IC),常用于驱动器、功率放大器件。

HSSOP与HSOIC封装
3.2.2 J形引脚小外形(SOJ)封装
SOJ(Small Outline J-leaded)的特点是引脚从封装两侧引出并向下弯曲呈"J"字形,末端向内收拢。这种方式结构稳定,焊接可靠性高,而且封装两侧的占用宽度更小。其缺点是高频性能受限(寄生电感可达0.8-1.2nH)和散热能力不足,目前应用较少。
SOJ封装
3.2.3小外形无引脚(SON)封装
SON(Small Outline No-lead)顾名思义就是无外伸引脚的小外形封装,它通过芯片底部的焊盘直接焊接至PCB。与SOP,SOJ相比SON的空间利用率高,寄生电感和电容低。SON封装也称为DFN(Dual Flat No-lead)双扁平无引线封装,DFN是由QFN(Quad Flat No-lead)封装衍生而来。

带散热焊盘的SON封装
SON也有很多衍生封装,如USON(Ultra-thin SON),VSON(Very-thin SON),WSON(Very Very thin SON),X2SON(eXtremely small and eXtremely thin SON)。
值得注意的是WSON中的W并不是Wafer-level的意思,而是Very Very的两个V放在一起,所以写作W。X2SON中的X2也不是双排焊盘的意思,而是两个极其的意思,eXtremely small与eXtremely thin。
如下表,Nexperia半导体的4引脚X2SON封装可以做到长0.6mm、宽0.6mm,高0.32mm。表中的P表示Pitch,即相邻引脚的中心间距。
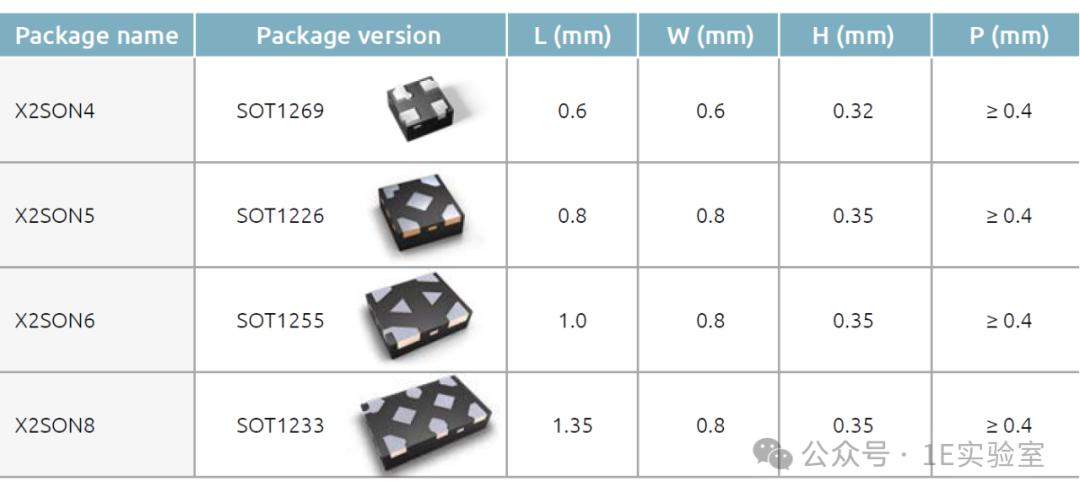
Nexperia公司X2SON封装参数
3.3 四边引出型表面贴装封装
与两侧引出的SOP、SOJ、SON封装类似,四边引出的封装类型有QFP,QFJ和QFN。前两个字母QF表示Quad Flat,概括了封装的四方扁平的特点。最后一个字母表示引脚类型:P表示Package,对应常规引脚;J对应J形引脚;N表示No-lead,无引脚。
3.3.1 QFP(Quad Flat Package,四方扁平封装)
QFP(Quad Flat Package)的特点是引脚从封装的四个边引出,呈“海鸥翼”(L)型,相比两侧引出的SON/DFN封装,其引脚密度更高。

QFP封装
QFP封装有很多衍生版本,按尺寸和厚度分类:
LQFP(Low-profile QFP)小尺寸四方扁平封装
TQFP(Thin QFP)薄型四方扁平封装
VQFP(Very-thin QFP)极薄四方扁平封装
按材料分类:
PQFP(Plastic QFP)塑料四方扁平封装
MQFP(Metal QFP)金属四方扁平封装
按散热与尺寸分类:
HQFP(Heat QFP)散热增强型四方扁平封装
HLQFP(Heat Low-profile QFP)散热增强小尺寸四方扁平封装
HTQFP(Heat Thin QFP)散热增强薄型四方扁平封装
HVQFP(Heat Very-thin QFP)散热增强极薄四方扁平封装
此外还有BQFP(Bumpered QFP) 带缓冲垫的四方扁平封装,它在芯片的四个角增加树脂缓冲垫,防止运输中的引脚弯曲。

BQFP封装
3.3.2 PLCC(Plastic Leaded Chip Carrier,塑料引线式芯片载体)与QFJ(Quad Flat J-leaded,四方扁平J形引脚封装)
PLCC(Plastic Leaded Chip Carrier)全称塑料引线式芯片载体,“Plastic”指塑料基材,“Leaded”强调外露的引脚,“Chip Carrier”表示芯片载体。PLCC封装的特点是引脚从封装的四个方向引出,向下、向内弯曲呈J型,具有结构稳定的优点。
使用陶瓷基材的这类封装叫CLCC(Ceramic Leaded Chip Carrier)陶瓷引线式芯片载体。

PLCC封装
PLCC/CLCC在20世纪80年代由美国的半导体厂商(例如TI)提出,但是后续又出现了LPCC(Leadless Plastic Chip Carrier无引线塑料芯片载体)和LCCC(Leadless Ceramic Chip Carrier,无引线陶瓷芯片载体),其中L既可以表示Leaded也可以表示Leadless,就很容易混淆。为了解决这个问题,日本电子机械工业会(EIAJ)于1988年正式将PLCC和CLCC统称为QFJ(Quad Flat J-leaded)四方扁平J形引脚封装。不过行业还是习惯性的沿用了PLCC的叫法,QFJ主要由日系厂商小范围使用。
PLCC/QFJ封装还有一个优势是能够适配测试/烧录底座,可以快速插拔。这主要得益于J形引脚外露且弯曲角度固定,而且PLCC标准化程度高,可直接匹配通用测试底座。PLCC封装常用于逻辑芯片,可编程器件与早期的存储器芯片。

PLCC封装芯片测试座
3.3.4 QFN(Quad Flat No-lead,四方扁平无引脚封装)
QFN(Quad Flat No-lead)封装的特点是无外延引脚,它通过封装底部四个方向的金属焊盘与PCB连接。相比QFP和QFJ,QFN封装的体积更小,更短的引脚降低了寄生电感,适用于高速信号场景。
与SON类似,QFN也有很多衍生版本:
LQFN(Low-profile QFN)薄型四方扁平无引脚封装
UQFN(Ultra-thin QFN)超薄四方扁平无引脚封装
VQFN(Very-thin QFN)极薄四方扁平无引脚封装
WQFN(Very Very-thin QFN)超极薄四方扁平无引脚封装
X1QFN(eXtremely thin QFN)极致薄型四方扁平无引脚封装
X2QFN(eXtremely small and eXtremely thin QFN)极致小型化且极致薄型四方扁平无引脚封装

QFN封装
QFN封装的一种变体是LCC(Leadless Chip Carrier)封装,又分为LPCC(Leadless Plastic Chip Carrier)无引线塑料芯片载体和LCCC(Leadless Ceramic Chip Carrier)无引线陶瓷芯片载体。

LCCC封装
3.4 阵列形表面贴装封装
3.4.1 LGA(Land Grid Array,触点阵列封装)
LGA(Land Grid Array)触点阵列封装,也称为焊盘阵列封装,是一种使用金属触点阵列替代传统引脚的芯片封装,其特点是通过平面触点与电路板上的插座弹性连接,具有高密度(如LGA775含775个触点)、低电感(信号传输路径短)等优势。

LGA封装的英特尔CPU与底座
相比BGA焊接式封装,LGA支持插拔更换,便于维护,但需精密对齐触点且插座成本较高。LGA封装广泛应用于高性能CPU(如Intel/AMD处理器)、服务器芯片及需要稳定连接的领域,在小型化设备中因底座体积限制多被BGA取代。
使用LGA封装的芯片除了与插座弹性连接,也可以通过SMT(Surface Mounted Technology,表面贴装技术)直接焊接到电路板上。
使用LGA封装的加速度计芯片
3.4.2 BGA(Ball Grid Array,球栅阵列封装)
BGA(Ball Grid Array)是一种高密度芯片封装,它通过底部规则排列的焊球阵列替代传统引脚,实现与PCB的连接。其特点包括高引脚密度(支持1000+ I/O)、紧凑体积(比QFP封装减少30%以上面积)和优异电热性能(短路径降低信号延迟,焊球改善散热)。
BGA技术由摩托罗拉等公司于20世纪90年代推动实用化,现已成为现代电子封装的主流方案。它广泛应用于CPU、GPU、智能手机SoC及5G通信芯片等高性能场景,但存在检测困难(需X光设备)、返修复杂(需专用植球工具)和成本较高(基板材料要求严格)等挑战。
BGA封装
根据材料不同,BGA分为:
PBGA(Plastic BGA)塑料球栅阵列封装
CBGA/CABGA(Ceramic BGA)陶瓷球栅阵列封装
根据尺寸不同,BGA又衍生出:
nFBGA(New Fine Pitch BGA)新型细间距球栅阵列,在TI公司的产品中广泛应用。有时也直接称为FBGA(Fine-Pitch BGA)。
TinyBGA 小型球栅阵列,这是Kingmax胜创的内存封装专利技术。
DSBGA(Die-Size BGA)晶粒尺寸球栅阵列,也称为WCSP(Wafer Chip Scale Package)晶圆芯片级封装。
FG(Fine-pitch Ball Grid Array)细间距球栅阵列封装
LFBGA(Low-profile Fine-pitch BGA)薄型细间距球栅阵列封装
VFBGA(Very-thin Fine-pitch BGA)超薄细间距球栅阵列封装
根据封装形式又衍生出:
FCBGA(Flip Chip BGA)倒装芯片BGA。倒装芯片不是一种芯片,而是指“倒装芯片键合”,是将晶粒(Die)倒置后与基板直接连接的键合形式,与传统的引线键合相比倒装芯片信号路径短,适合更高性能的芯片。
POP-BGA(Package-on-Package BGA),即垂直堆叠多个 BGA 封装(如逻辑芯片 + 存储器),节省 PCB 空间。常用于高性能 SoC ( System on Chip )芯片。
PG-WF2BGA(Plastic Grid Wafer-Level Fan-Out 2nd Generation BGA)使用塑料网格基板,采用第二代晶圆级扇出技术的球栅阵列封装。
3.4.3 阵列封装对比
阵列封装主要包括PGA(Pin Grid Array)插针阵列、LGA(Land Grid Array)触点阵列和BGA(Ball Grid Array)球栅阵列三种。
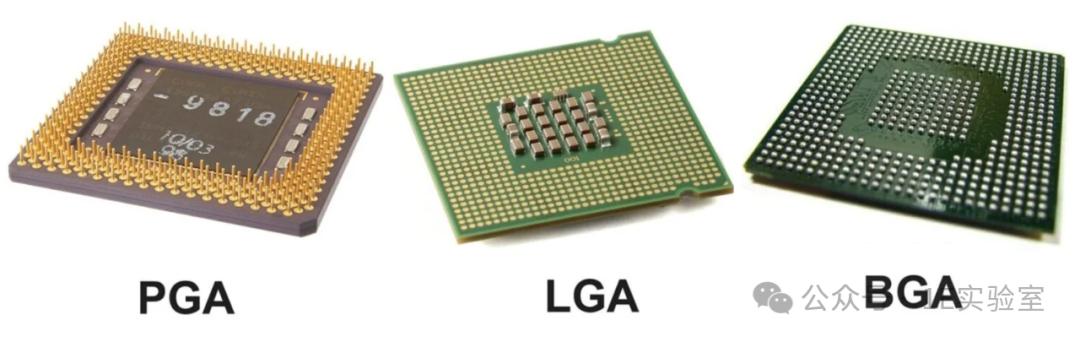
三种阵列封装对比
PGA的特点是自带插针,多用于早期CPU;LGA采用平面金属触点与主板弹性针脚对接;BGA底部锡球直接焊接,所需空间最小。
性能上,PGA信号延迟最高,LGA次之,BGA最优。应用上,PGA主要面向工控等特殊领域,LGA主导高性能计算(如Intel/AMD处理器),BGA则垄断移动设备。
3.5 CSP(Chip Scale Package,芯片级封装)
CSP(Chip Scale Package)芯片级封装是一种先进的芯片封装技术,其封装尺寸接近裸芯片,也就是晶粒(Die)本身的大小(通常不超过Die面积的1.2倍,而传统封装通常是2~5倍)。CSP使用锡球阵列作为引脚,焊球间距一般是0.2-0.5mm,而BGA的焊球间距通常是0.3-1.0mm。CSP封装具有极致小型化、更高密度I/O和优异电气性能的特点。
实际上CSP就是一种小型化的BGA封装。FBGA(Fine-Pitch BGA)和VFBGA(Very Thin Fine-Pitch BGA)都可以归类为CSP封装。

CSP封装
3.5.1 WLCSP(Wafer-Level Chip Scale Package,晶圆级封装)
WLCSP(Wafer-Level Chip Scale Package)晶圆级芯片封装又称为WLP(Wafer-Level Package),是直接在晶圆(Wafer)上完成成所有封装步骤,如形成重新布线层(RDL,Redistribution Layer)和植球。其最重要的特点是无需基板,也没有塑封环节。WLCSP封装的尺寸接近裸芯片(即晶粒,Die)的大小,具有体积小、成本低、性能优等优点,广泛应用于移动设备、传感器等领域。
相比之下,传统的CSP和BGA封装则需要先将晶圆切割成单个晶粒,再通过引线键合(Wire Bonding)或倒装芯片(Flip-Chip)的方式将晶粒连接到基板(如引线框架、树脂基板)上,最后再进行塑封。
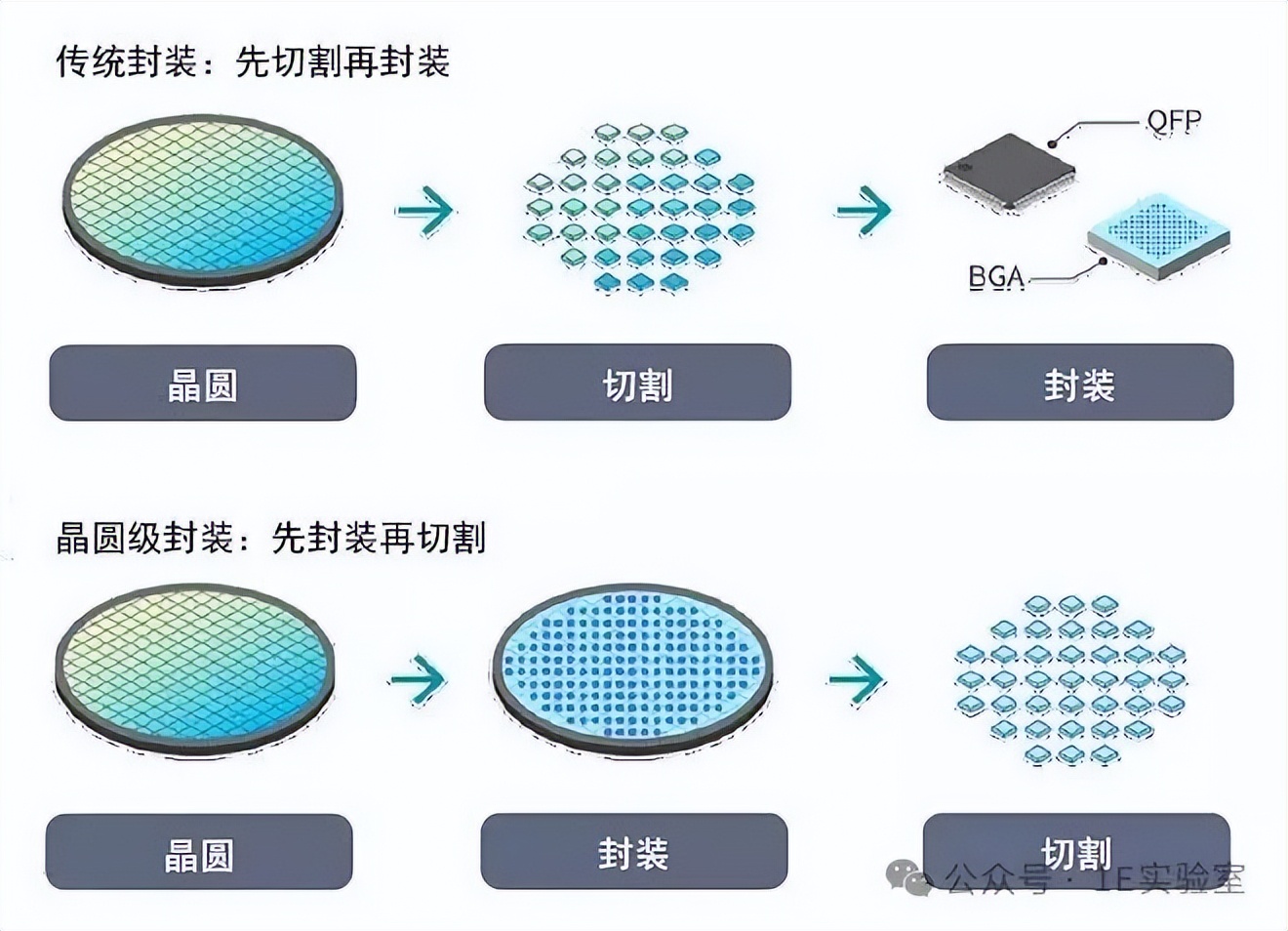
传统封装与WLCSP/WLP流程对比
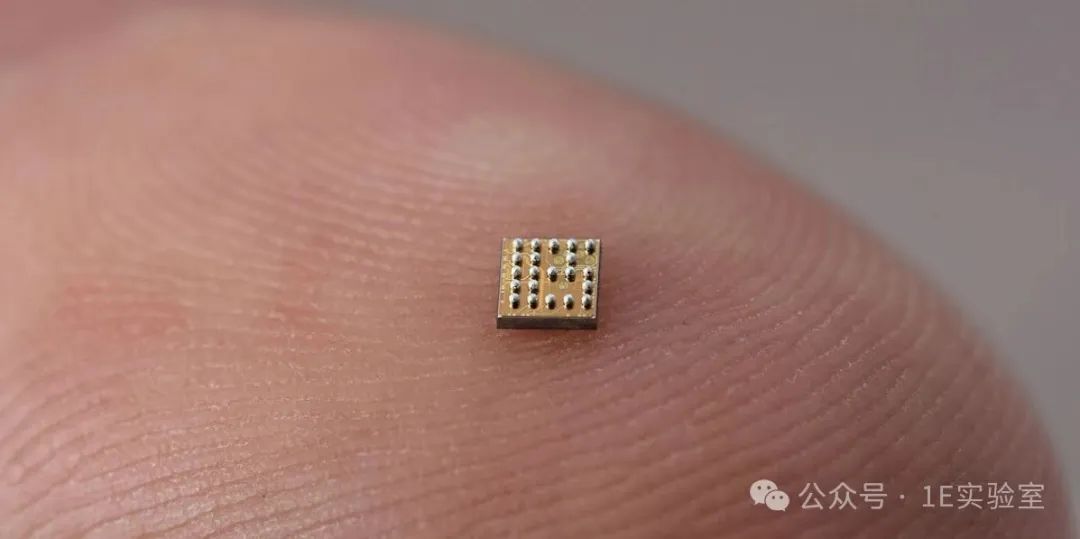
WLCSP封装
WLCSP又分为扇入型(Fan-In)和扇出型(Fan-Out)两类。
Fan-In WLCSP一般直接称为WLCSP,其特点是焊球全部位于裸芯片区域内,封装尺寸=裸芯片尺寸。Fan-In WLCSP封装是先在晶圆层面完成封装工艺,再切割后即形成独立器件,这种技术显著降低了生产成本,同时实现了与裸芯片尺寸近乎一致的封装体积。适用于低引脚数芯片,如传感器芯片、简单逻辑芯片。
Fan-Out WLCSP,简写为FO-WLCSP,也有厂商会使用专有名称,如台积电的InFO(Integrated Fan-Out),三星的FO-PLP(Fan-Out Panel-Level Packaging)。其特点是焊球可延伸至裸芯片外部,封装尺寸>裸芯片尺寸。其原理是通过重构晶圆(Reconstituted Wafer)技术扩展封装区域,工艺复杂但性能更强,I/O密度高,适合高性能、高集成需求。
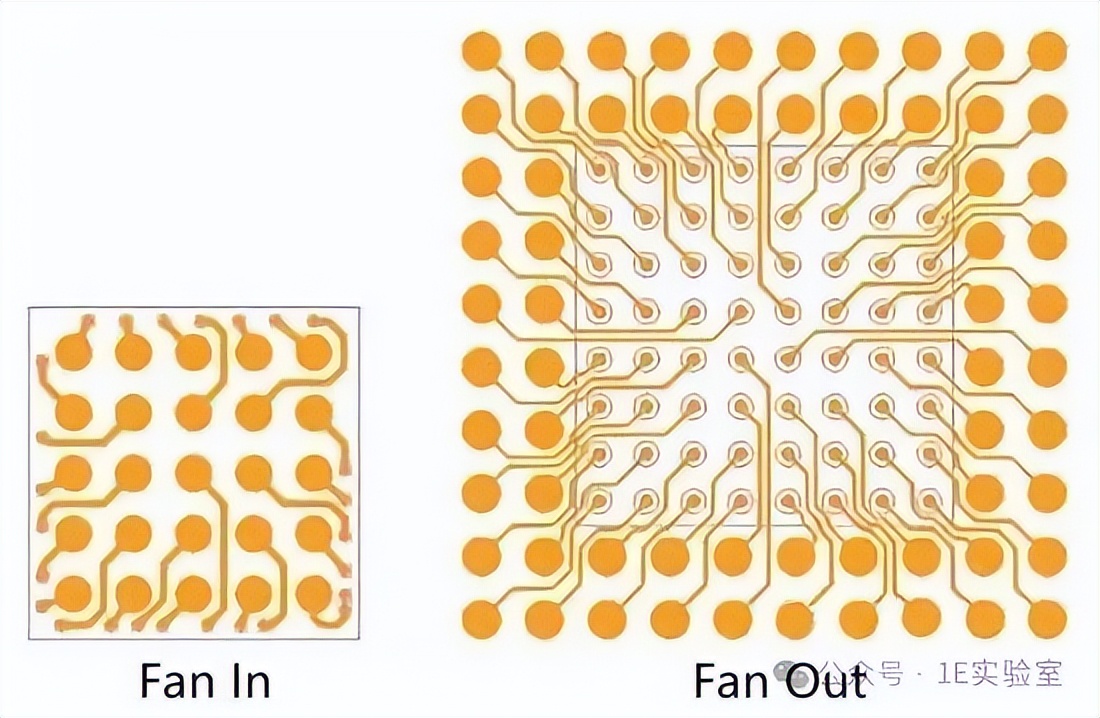
扇入型和扇出型WLCSP封装引脚示意图

扇入型和扇出型WLCSP封装结构示意图
此外,(Fan-In)WLCSP封装因成本较低,体积小,所以也被用于一些TVS二极管中。如下图所示采用WLCSP封装的TVS二极管在外观上呈现半导体基材的自然切面结构,与传统封装(如DFN0603-2L)采用的模塑树脂包裹工艺明显不同。

两种TVS二极管的封装
3.5.2 BGA, CSP, WLCSP封装对比
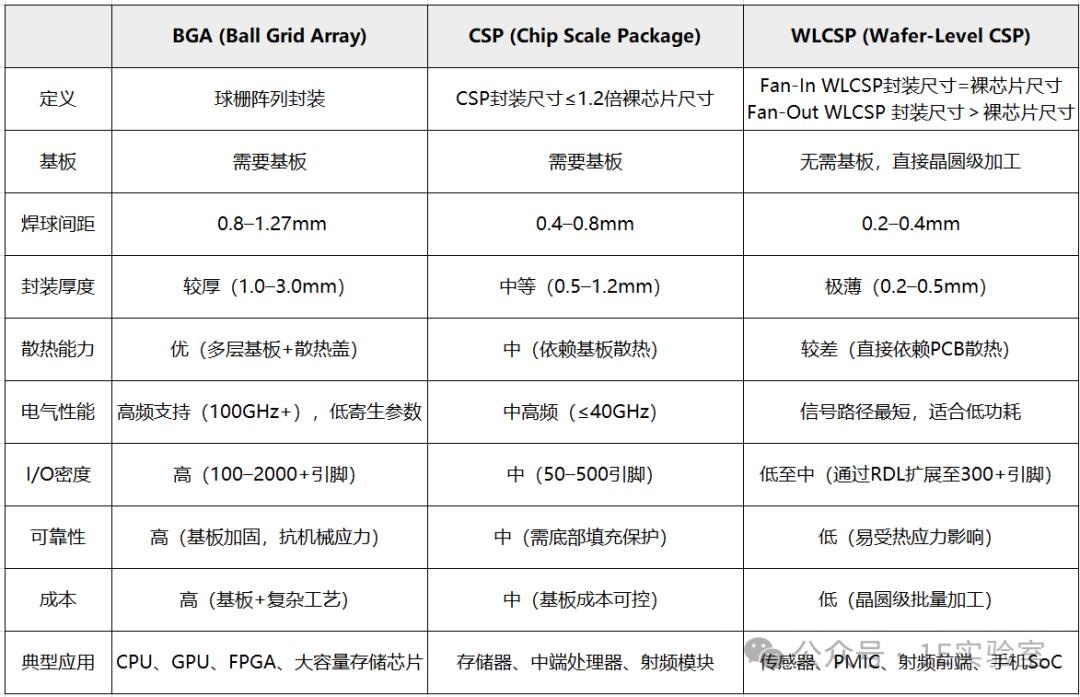
4 芯片封装类型与键合技术的关系
芯片封装键合技术简介介绍了芯片封装过程中的键合技术,键合就是裸芯片与引线框架或基板的连接方式,是封装环节中的核心工艺。而本文介绍的封装类型主要是从芯片的物理形态上分类,两者是不同维度的概念。
通常来说,低引脚密度、低成本的传统封装类型(如DIP、QFP)通常使用引线键合;高密度、高性能的的封装类型(如BGA、CSP)则更多使用倒装芯片键合。
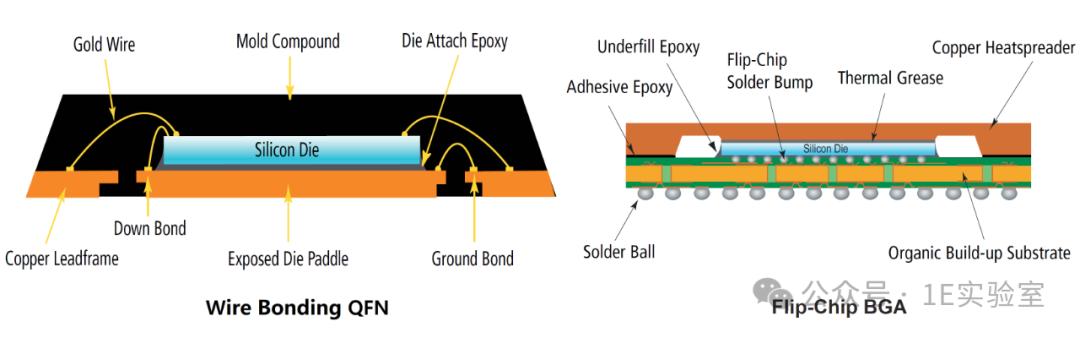
使用引线键合的QFN与倒装芯片BGA示意图
5 总结
芯片封装可分为传统封装和先进封装两大类。传统封装又包括通孔插装封装,表面贴片封装和面积阵列封装三大部分,本文尽可能全面的介绍了传统封装,也简单介绍了 FCBGA, WLCSP,Fan In/Fan Out 等先进封装。更多的先进封装如TSV ( Through-Silicon Via),SiP ( System in Package),PoP( Package on Package),2.5D/3D IC等将会在后续文章中进行介绍。
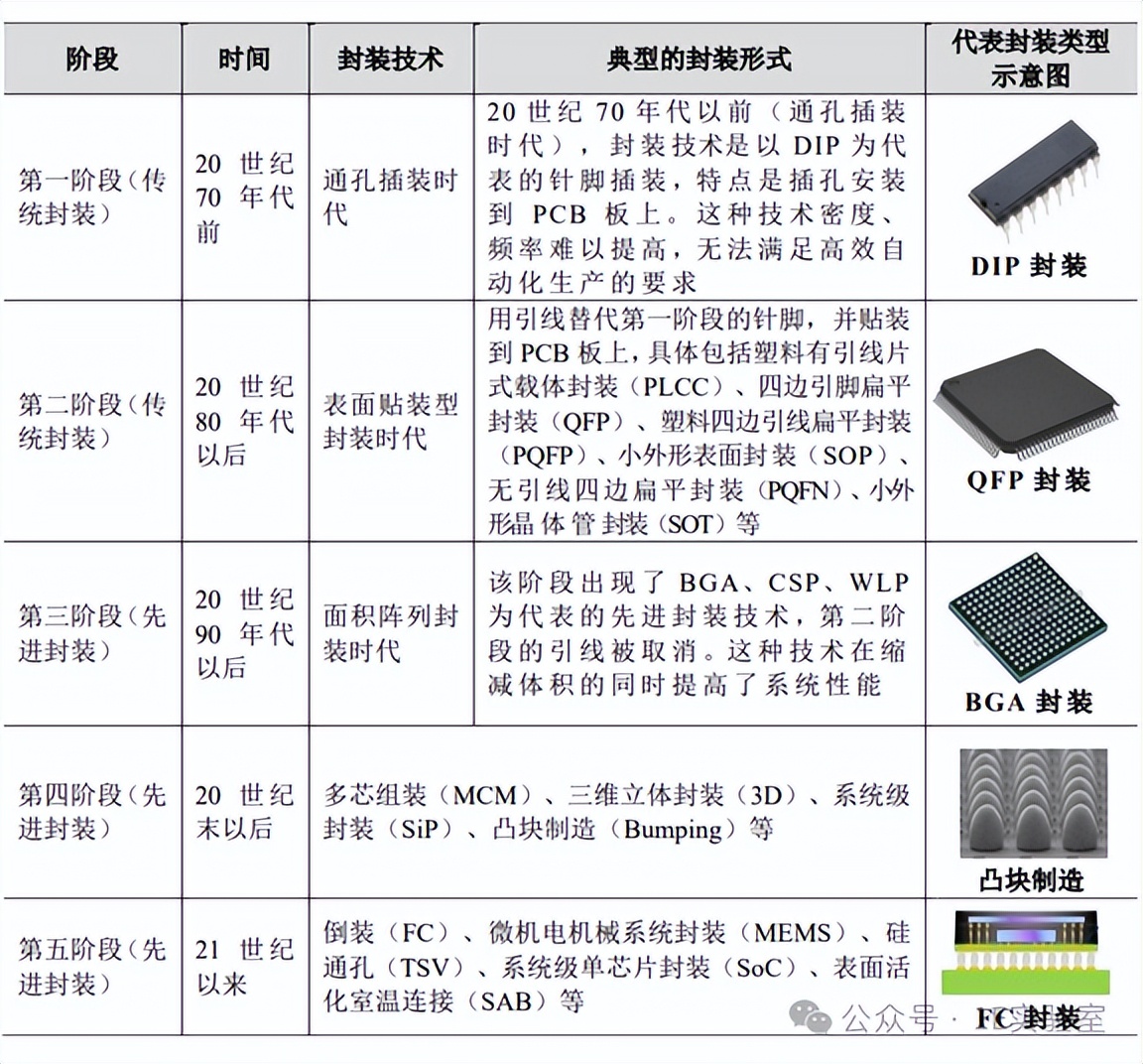
芯片封装类型的演进
最后对本文出现的所有封装列一个中英文名称对照表,蓝色部分为衍生封装:

